La dispersión de rayos X se usa de forma rutinaria para determinar la estructura, la orientación, los parámetros de red y la calidad cristalina en materiales cristalinos (difracción de rayos X), y el espesor, la densidad y la rugosidad de películas delgadas y multicapas (reflectividad de rayos X).
La configuración de este equipo está optimizada para estudios de difracción de rayos X de alta resolución (HR-XRD) y reflectividad de rayos X (XRR) en películas delgadas y superredes nanoestructuradas. Para ello incluye monocromadores en los haces incidente y difractado, colimadores, atenuadores y un portamuestras euleriano.
Además, permite realizar mapas locales gracias al desplazamiento lateral motorizado de muestras planas.
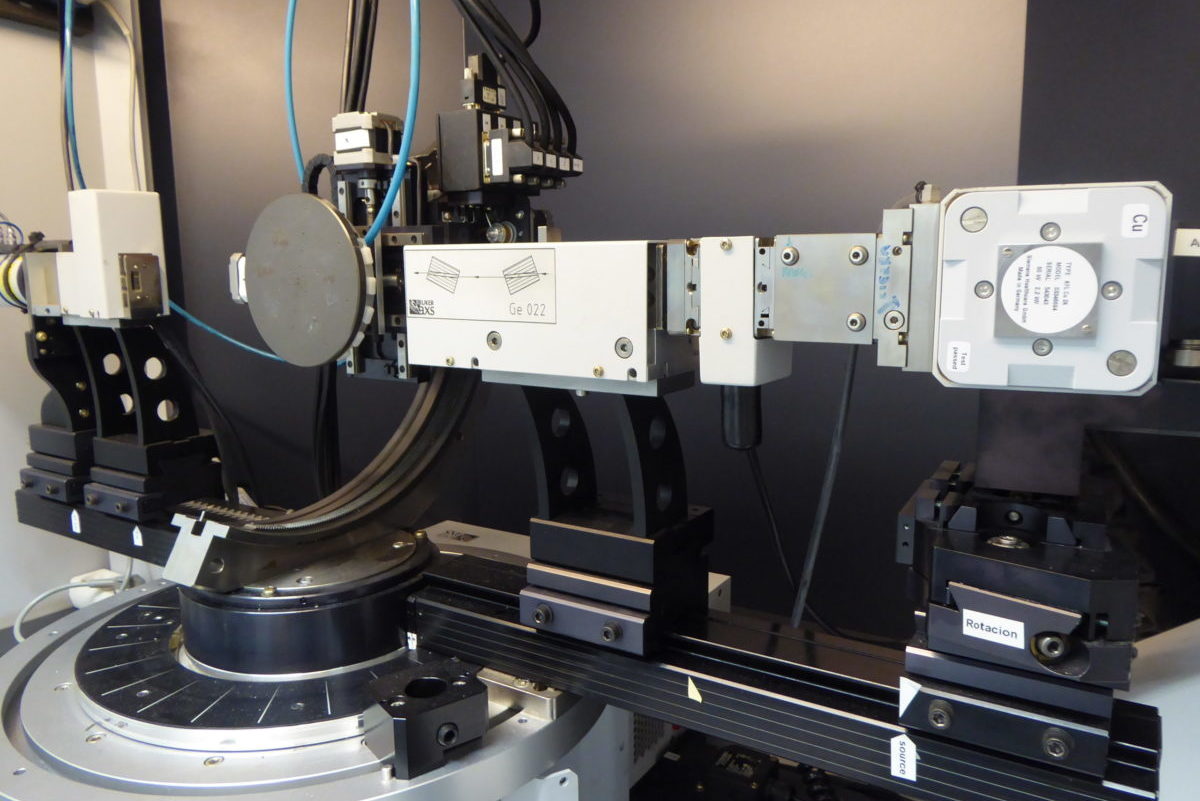
La XRD en el LMA utiliza un difractómetro D8 Advance de Bruker Española S.A. Este instrumento tiene varios modos de operación, incluyendo:
- Difracción de alta resolución en películas y multicapas epitaxiales
- Mapas del espacio recíproco
- Mapas locales en obleas extensas
- Reflectividad de rayos X
- Caracterización estructural de películas monocristalinas o texturadas
- Difracción en incidencia rasante (GID)
El equipo de XRD es utilizado principalmente por investigadores que trabajan en el crecimiento de películas delgadas epitaxiales en las siguientes líneas:
- Películas delgadas tensionadas epitaxialmente
- Películas y nanoestructuras magnéticas para aplicaciones en Spintrónica
- Películas delgadas y multicapas multiferroicas
- Películas de materiales con efectos termoeléctricos (como el efecto Seebeck de spin)
La experiencia de nuestro personal científico y técnico está a disposición de los investigadores de centros de investigación públicos y privados, así como a profesionales del sector industrial que requieran del uso de este instrumento.

Medida de XRR (línea negra) y ajuste usando el programa Leptos® de Bruker (línea rosa) en una heteroestructura epitaxial MgO//Fe3O4/MgO/Fe/MgO. En la tabla se recogen los valores de espesor y rugosidad (desviación cuadrática media).

Mapa del espacio recíproco medido alrededor de la reflexión pseudocúbica 013 en una heteroestructura epitaxial SrRuO3/BaTiO3 crecida sobre un sustrato de GdScO3.
Las técnicas XRD y XRR proporcionan la siguiente información en películas delgadas:
- Composición química
- Estructura cristalina
- Parámetros de red
- Orientación de sustrato y película
- Ángulo de desviación del corte en sustratos monocristalinos
- Calidad cristalina y textura
- Rugosidad
- Densidad
- Espesor
- Defectos, dislocaciones
- Tensión
- Fuente de rayos X con ánodo de cobre
- Monocromador de Ge (022) (línea Cu Kα1)
- Óptica de haz paralelo (espejo de Göbel)
- Cuna euleriana y plataforma de traslación XYZ
- Plataforma reclinable (Zeta y Xi) para incidencia rasante
- Dispositivo de succión para fijar muestras planas
- Rendijas de Soller
- Atenuador del haz de rayos X
- Control automático de alineamiento con microscopio y láser
- Detector de centelleo
- Programas de análisis y bases de datos

Universidad de Zaragoza

Ministerio de Ciencia, Innovación y Universidades

Actividad de I+D+I realizada por la Universidad de Zaragoza cofinanciada por el Gobierno de Aragón
Laboratorio de Microscopías Avanzadas
Somos una iniciativa singular a nivel nacional e internacional. Ponemos a disposición de la comunidad científica e industrial las infraestructuras más avanzadas en microscopía electrónica y de sonda local para la observación, caracterización, nanoestructuración y manipulación de materiales a escala atómica y molecular.
Datos de Contacto
Campus Río Ebro, Edificio Edificio I+D+i
Enlaces Destacados
© 2023 LMA| Página web desarrollada por o10media